【摘要】 Abhishek Vatsal等人[1]开发一种在线测量技术,利用x射线光电子能谱(XPS)来测量低k介电薄膜的图像化沟槽表面的光电子强度。
半导体工业不断努力实现更小的节点尺寸,以提高电子芯片的性能。这种性能的增强主要围绕着减小晶体管的尺寸,同时提高它们的速度和密度。通过逐渐用低介电常数(k)低于2.8的新型碳掺杂SiO2基介电材料(称为SiCOH)取代常用的SiO2介电材料来解决层间电容问题。
因此,Abhishek Vatsal等人[1]开发一种在线测量技术,利用x射线光电子能谱(XPS)来测量低k介电薄膜的图像化沟槽表面的光电子强度。数学模型使用线性回归方法将强度分离为组成表面的单个元素组成。模型的初始部分使用来自CD-SEM和光谱椭偏仪的测量数据来确定XPS电子分析仪可见的各自表面积。
在较小的技术节点上,等离子体引起的损伤会严重阻碍低介电常数电介质与半导体制造工艺的集成。了解等离子体过程对低介电常数介电材料表面和块体的影响至关重要。全氟化碳和氢氟碳化物气体通常用于蚀刻低介电常数电介质,因为它们能够提供氟并容易与电介质中的硅反应形成挥发性 Si-Fx化合物,导致介质膜的去除。蚀刻过程涉及在蚀刻结构的表面上形成钝化碳氟化合物层(FC层)。
该层的化学性质和厚度由各种蚀刻参数决定。FC层控制离子和自由基进出底层低k介电层的扩散,从而影响蚀刻动力学,从而决定低k介电薄膜中蚀刻速率和等离子体诱导损伤程度的刻蚀动力学。此外,它还可以防止横向蚀刻。1在图案蚀刻结构中,水平表面主要受等离子体离子轰击的影响,而垂直侧壁主要受自由基的影响,导致每个表面的成分和性质不同。2为了了解等离子体对蚀刻介质薄膜的损伤,表征图案蚀刻结构的水平和垂直表面上的FC层至关重要。
根据光电子强度、发射面积和每个表面的特征元素组成之间的线性关系推导出线顶、沟槽底和垂直侧壁的表面组成。如图a和图b通过蚀刻(受光刻胶保护)域的总堆栈高度与未蚀刻(受光刻胶保护)区域的堆栈高度相减,可以精确地确定沟槽深度。该研究通过物理测量验证了模型预测的成分,证明了与商业CCP RIE蚀刻室中应用蚀刻和灰分化学的物理机制的良好一致性和一致性。
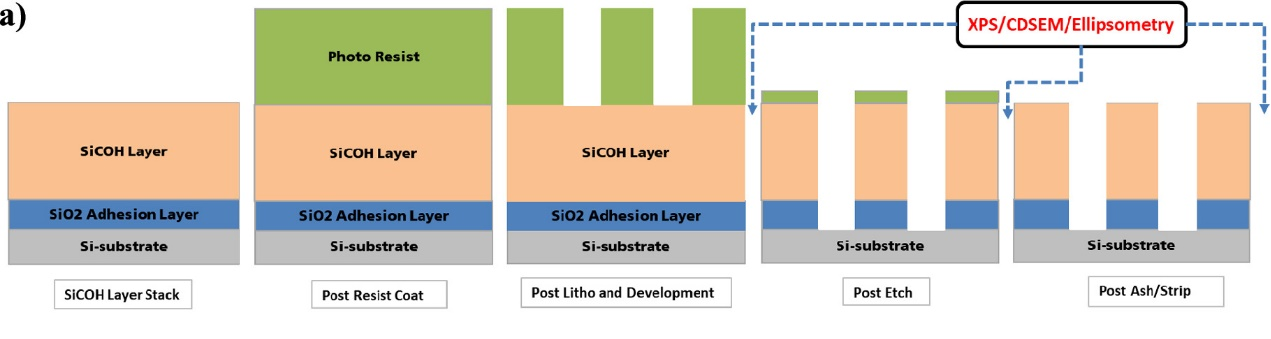
图a SiCOH膜堆蚀刻工艺示意图
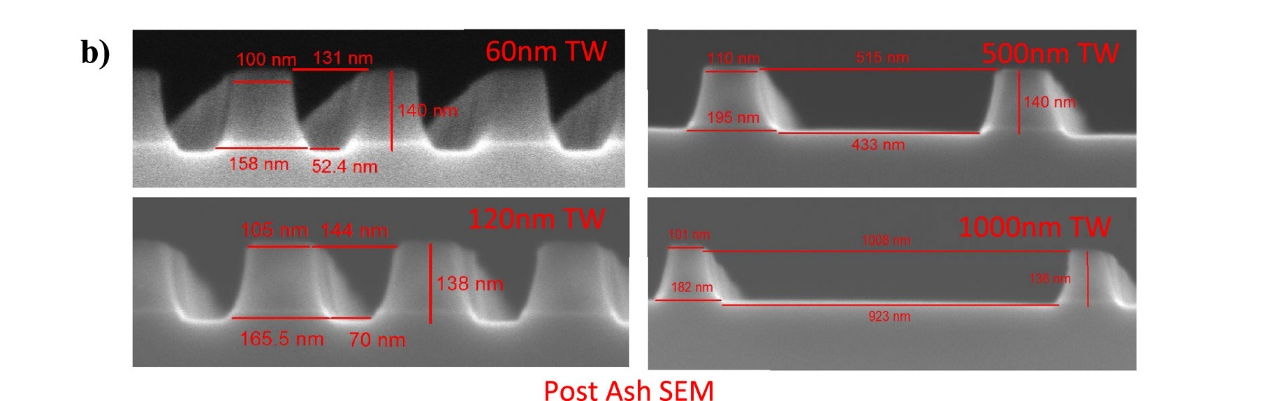
b四种不同测试场灰后的SEM横截面
综上所述,该研究重点讨论了XPS光电子强度分解技术,利用多元线性回归计算各海沟表面的化学成分。通过临界尺寸扫描电子显微镜(CD-SEM)和光谱椭偏仪获得了沟槽轮廓的实际尺寸。考虑了光电子遮蔽效应对XPS强度采集的影响,特别是对于较窄的沟槽几何形状。为了验证该技术的准确性并识别潜在的局限性和误差,将模型结果与使用蚀刻气体组合的蚀刻晶圆上的物理测量结果进行了比较。
[1]. Vatsal, A.; Rudolph, M.; Oehler, S.; Brackmann, V.; Bartha, J. W., Model-Based XPS Technique for Characterization of Surface Composition on Nano-Scale SiCOH Sidewalls. ECS Journal of Solid State Science and Technology 2023, 12 (12), 124001.
科学指南针已获得检验检测机构资质认定证书(CMA)、实验动物使用许可证、“ISO三体系认证”等专业认证,提供材料测试、高端测试、环境检测、生物服务、模拟计算、科研绘图、数据分析、试剂耗材、行业解决方案、指南针学院等多项科研产品和服务矩阵。企业致力于为高校、科研院所、医院、研发型企业等科研工作者,提供专业、快捷、全方位的检测及科研服务。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2024-07-31
2024-07-31
 3919
3919
 0
0










