【摘要】 Seiichi Kondo团队研发铜AFP无磨料抛光技术,通过化学-机械协同作用实现精准停抛。过抛光腐蚀深度降低80%,铜线电阻一致性提升40%,结合干法刻蚀解决芯片制造CMP工艺缺陷。
金属化学机械抛光(CMP)长期面临磨料导致的工艺缺陷。日本研究团队Seiichi Kondo等人创新性地开发出铜大马士革互连无磨料抛光工艺(AFP),通过结合新型铜AFP技术与阻挡金属干法刻蚀,彻底解决了传统CMP的腐蚀难题。
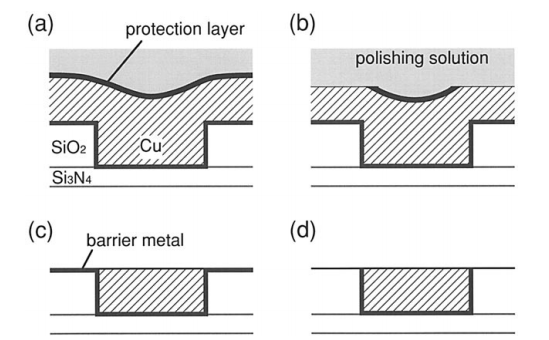
图1 Cu AFP的机理:(a)保护层的形成,(b)突起区域的磨损,(c)阻挡金属层的抛光停止,(d)阻挡金属层的去除。
一、无磨料抛光核心原理
铜AFP工艺采用特殊水基溶液(含氧化剂/蚀刻剂/缓蚀剂)和发泡聚氨酯垫,通过"软摩擦"实现精准平面化:
1.氧化剂生成铜氧化膜,缓蚀剂形成保护层(图1a)
2.凸起区域保护层被抛光垫摩擦去除,暴露铜被蚀刻(图1b)
3.平面化后自动停抛于阻挡金属层(图1c)
4.结合选择性干法刻蚀完成阻挡层去除(图1d)
二、过抛光性能对比实验
关键突破体现在过度抛光耐受性上。当抛光时间延长至工艺要求的200%时:
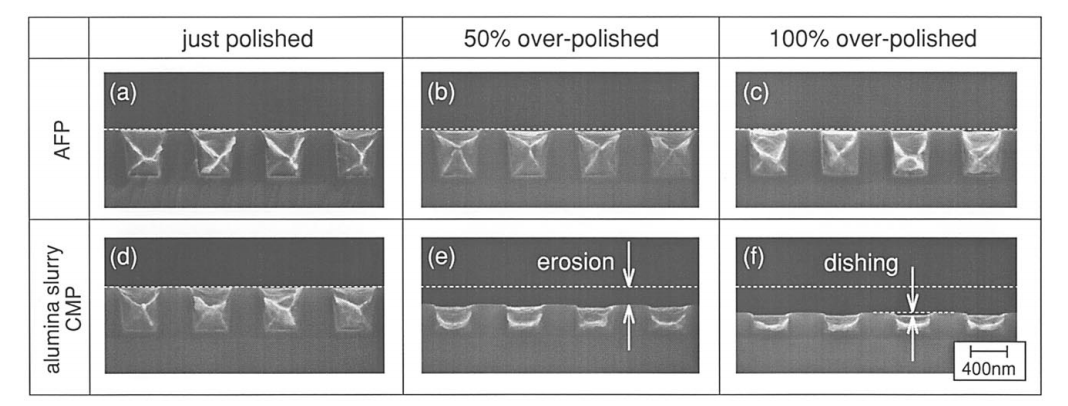
图2 AFP与传统氧化铝浆料CMP的侵蚀深度进行了比较。采用刚抛光、50%过抛光和100%过抛光样品对Cu线阵列进行截面成像
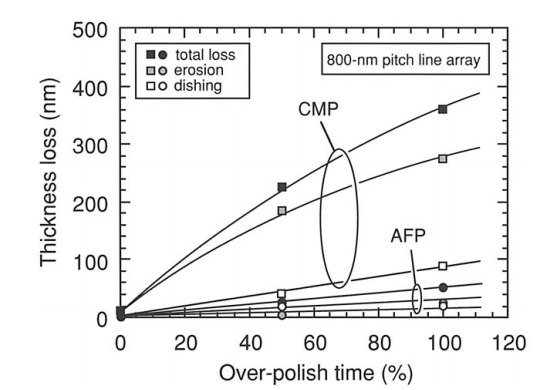
图3 在狭窄的Cu线阵列区域,AFP和常规CMP的过抛光时间对腐蚀和碟形深度的影响
三、半导体制造工艺优势
1.零划痕表面:消除磨料带来的物理损伤
2.过抛安全保障:阻挡金属层选择性停抛机制
3.电阻一致性提升:铜线电阻偏差降低40%
4.环保效益:减少30%废浆料处理成本
5.工艺整合性:与干法刻蚀(SF6气体)完美兼容
参考文献:[1] Seiichi Kondo et al 2000 J. Electrochem. Soc. 147 3907
科学指南针已获得检验检测机构资质认定证书(CMA)、实验动物使用许可证、“ISO三体系认证”等专业认证,并荣获国家高新技术企业、国家“互联网+科研服务领军企业等多项荣誉。未来,科学指南针将继续朝着“世界级科研服务机构”的目标,在产品研发和用户服务等方面持续努力,为科学发展和技术创新做出更大贡献。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2025-07-28
2025-07-28
 2515
2515
 0
0










