【摘要】 SEM中的晶体学技术依赖于对接近初级电子束能量的背散射或前散射电子(BSE/FSE)的检测,这些电子源具有更高的电子背/前散射信噪比和更小的探针尺寸。
几十年来,扫描电子显微镜(SEM)的不断进步有助于获得高分辨率和图像质量。
提高SEM性能的主要集中在提高电子源的亮度和减轻电子光学系统中的基本像差。
通过用传统的热离子电子发射枪代替场发射枪(FEG),已经取得了很大的改进。
热离子灯丝尖端尺寸较大,直径可达几十微米,与亮度相对较低有关,并且在运行过程中会发生阴极材料的蒸发和热漂移。
另一方面,FEG发射器的场发射尖端半径低至几十纳米,产生的电子束直径比热离子发射器小两个数量级,电流密度或亮度大三个数量级,这显著提高了信噪比、空间分辨率、发射器寿命和可靠性。
SEM中的晶体学技术依赖于对接近初级电子束能量的背散射或前散射电子(BSE/FSE)的检测,这些电子源具有更高的电子背/前散射信噪比和更小的探针尺寸。
较低的加速电压有利于减少用于大块样品研究的探针体积。
这意味着空间分辨率的提高,但另一方面,低加速度电压与电子光学像差的增加以及对污染效应的更高敏感性有关。
限制晶体学分析中SEM性能的另一个因素是电子光学像差,主要是球面和色差。
球面像差是由远离透镜光轴的光线与靠近光轴的光线之间的焦距差异引起的。
色差的发生是因为 SEM 中物镜的焦距随通过它的电子的能量而变化。
FEG 的使用有助于减轻色差,因为它们产生的光束能量分布较窄,即低 dE(电子束的能量扩散)。
当需要低加速度(低E)时,SEM分辨率会大大降低,这个问题促使人们研究另外两种方法来抵消色差:使用单色器和像差校正器[1]。
单色器缩小了电子束的能量扩散dE,从而提高了低能量下的SEM图像分辨率。
像差校正器由多级四极杆-八极杆光学器件组成,可降低像差系数。
不幸的是,使用像差校正的SEM会带来巨大的额外成本,与对准程序相关的困难,以及由于这种类型的镜头所需的更大数值孔径而产生的成像景深的降低。
高分辨率SEM的另一项创新是通过引入磁浸没镜头(将样品放置在镜头磁场内)以及高信号收集效率的镜头内探测器来缩短标本与透镜之间的距离。
原理图图1a 显示了镜头内物镜的示例和图1b展示了一个带有透镜二次电子探测器的半透镜物镜。
但是,浸没式镜头受到限制。
其中之一是某些试样的磁性所施加的限制。
另一个不良影响是它们的磁场对EBSD相机方向上的衍射电子的影响。
这会导致衍射图案弯曲,需要对其进行校正以使菊池带变平。
物镜的最新设计之一是所谓的混合透镜,这是一种由电磁透镜和静电透镜组成的复合透镜。
与半透镜物镜不同(图1b)、混合透镜不会在极片下方泄漏电磁场。
通过将电磁场叠加到物镜中的静电场上,可以防止磁场泄漏到试样上。
因此,可以在低加速电压下对磁性样品(例如铁合金)进行高分辨率观察。
在SEM中使用晶体学方法时,另一个至关重要的一般考虑因素是样品制备。
在过去的几年中,样品制备方法和仪器与SEM技术同步得到改进。
例如,通过聚焦离子束 (FIB) 进行样品制备程序和宽离子束 (BIB)(图2)。
此外,电解抛光和振动抛光等传统方法在这个新领域变得重要。
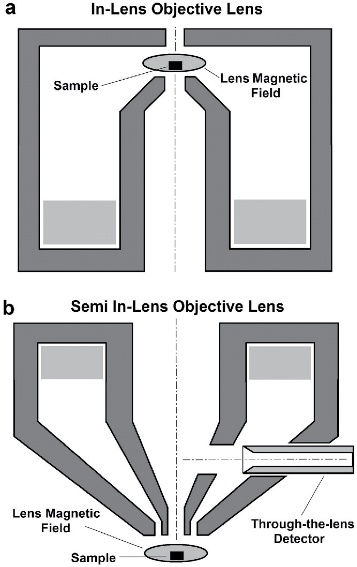
图1. 用于低试样-透镜距离的两种高分辨率SEM磁浸没物镜的示意图:(a)透镜内物镜和(b)带有透镜二次电子探测器的半透镜内物镜[2]
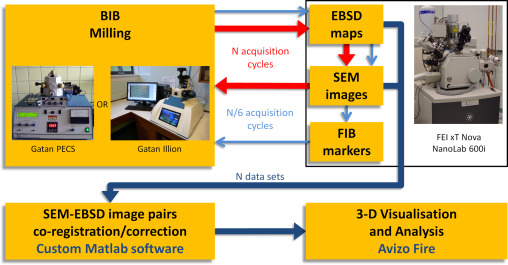
图2.宽离子束连续切片断层扫描的工作流程[3]
[1] Ogawa T , Cho B , Ahn S J .Low-energy scanning electron microscope using a monochromator with double-offset cylindrical lenses[J].Journal of Vacuum Science and Technology B: Nanotechnology and Microelectronics, 2015, 33(6):06FJ01.
[2] Rafael Borrajo-Pelaez. Recent Developments of Crystallographic Analysis Methods in the Scanning Electron Microscope[J]. Critical Reviews in Solid State and Materials Sciences, 2017, 43: 455-474.
[3] Winiarski, B.Gholinia, A.Mingard, K.Gee, M.Thompson, G. E.Withers, P. J.Broad ion beam serial section tomography[J].Ultramicroscopy, 2017, 172.
科学指南针以分析测试为核心,提供材料测试、环境检测、生物服务、模拟计算、科研绘图等多项科研产品,累计服务1800+个高校、科研院所及6000+家企业,获得了60万科研工作者的信赖。始终秉持“全心全意服务科研,助力全球科技创新”的使命,致力于为高校、院所、医院、研发型企业等科研工作者提供专业、快捷、全方位的服务。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2024-07-25
2024-07-25
 4255
4255
 0
0










