【摘要】 由于它们的正常运行对整个最终产品的可靠性至关重要,因此有关质量控制的问题对半导体器件制造商来说至关重要。
半导体器件是许多电子电气产品的关键部件,例如手机、电脑、汽车部件或飞机的控制单元[1]。
由于它们的正常运行对整个最终产品的可靠性至关重要,因此有关质量控制的问题对半导体器件制造商来说至关重要。
汽车工业的半导体器件的设计和生产的特点是高可靠性要求,以确保这些器件在其整个生命周期内的正常功能。制造商对其产品进行了广泛的测试,例如模拟产品必须承受的严格要求的高温操作寿命(HTOL)测试。
为了使设备符合将来的使用要求,制造商将其产品暴露于各种压力测试中,例如湿度测试、存储测试、温度循环测试和高温工作寿命测试(。这些测试的测量结果可以让制造商得出有关设备未来性能的结论,并证明其可靠性。

图1 早期分离合格和不合格设备的测试限值[1]。
在目前的工作中,工作的重点是高温工作寿命(HTOL)测试,其中高温水平导致设备人为地快速老化。
更具体地说,这些HTOL测试通常在150℃结温下进,即设备电路本身的工作温度,其中使用条件的加速由Arrhenius定律描述,假设活化能为0.7 eV。
这使得制造商可以计算出在HTOL测试条件下,现场设备的操作小时数对应于特定时间。Hofer等人提供了一个模型来确定这些HTOL测试的测试极限,以便在整个指定的产品寿命期内满足预定义的可靠性目标。
图1以图形方式描述了早期分离合格和不合格设备的测试限值的方法。果一个扩展只在一个方向上可行,则在该方向上实现扩展。如果在下方向和上方向都不可行,则步长减小到其值的一半。此过程继续进行,直到满足停止准则,即后续两次迭代的测试极限的绝对差值小于给定精度值(图2)。
这些测试限值的计算使得在整个产品使用寿命内,所考虑的电气参数在预定义的概率内保持在其规格限值内。
此外,本质量控制程序可能造成的产率损失应尽可能小。这些测试限值可用于自动化测试设备,在生产后立即检测合格和不合格的设备。进行了大量的数值模拟,以证明该模型在各种不同的器件内部和内部变化情况下的性能。
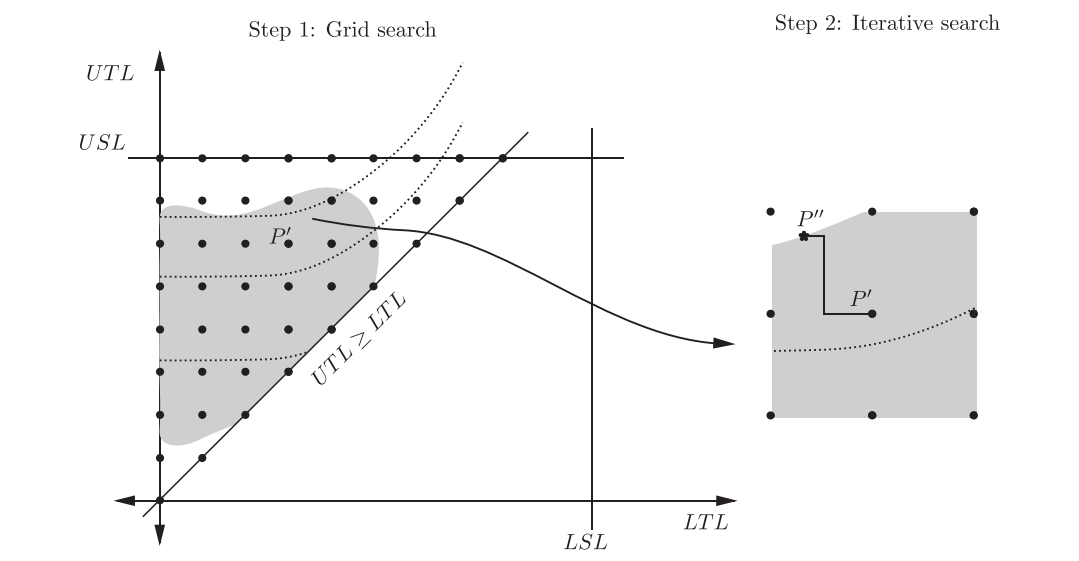
图2 优化问题的两步求解过程[1]。
[1] Hofer, V., Nowak, T. and Lewitschnig, H. (2021), Spline-Based Drift Analysis for the Reliability of Semiconductor Devices. Adv. Theory Simul., 4: 2100092.
科学指南针以分析测试为核心,提供材料测试、环境检测、生物服务、模拟计算、科研绘图等多项科研产品,累计服务1800+个高校、科研院所及6000+家企业,获得了60万科研工作者的信赖。始终秉持“全心全意服务科研,助力全球科技创新”的使命,致力于为高校、院所、医院、研发型企业等科研工作者提供专业、快捷、全方位的服务。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2024-07-23
2024-07-23
 5697
5697
 0
0










