【摘要】 研究表明,尽管C掺杂有利于费米能级的向下移动,但当C浓度超过阈值(此处为2×1018 cm−3)时,费米能级将沿相反的方向移动,最终位于带隙的上部。
硅上GaN由于其在高击穿电压、高频、高温操作方面的优异性能以及与硅CMOS工艺兼容的优势,已成为下一代功率电子器件最有前途的候选者之一。对于硅上GaN基高电子迁移率晶体管(HEMT),为了实现高电阻率GaN缓冲,通常引入碳(C)以引入深受主来补偿无意掺杂的GaN中的背景施主。在Shan Wu等人的工作中,通过使用上述带隙光辅助kelvin探针力显微镜(PA-KPFM)和塞贝克系数测量,揭示了通过MOCVD生长的C掺杂GaN的费米能级和n型电导率的后移,而不是将费米能级钉扎在CN受体周围。
研究表明,尽管C掺杂有利于费米能级的向下移动,但当C浓度超过阈值(此处为2×1018 cm−3)时,费米能级将沿相反的方向移动,最终位于带隙的上部。n型导电性归因于自补偿和随C掺杂引入的其他施主型补偿中心。其中KPFM的测量原理示意图如图1所示。可以得出结论,当C浓度从2×1016 cm−3增加到2×1019 cm−3时,VCPD值降低,表明费米能级的总体下移。我们应该提到的是,由于半绝缘GaN,的强表面能带弯曲和偏置偏移,很难估计实际的体费米能级位置,这是非常复杂的,值得进一步研究。
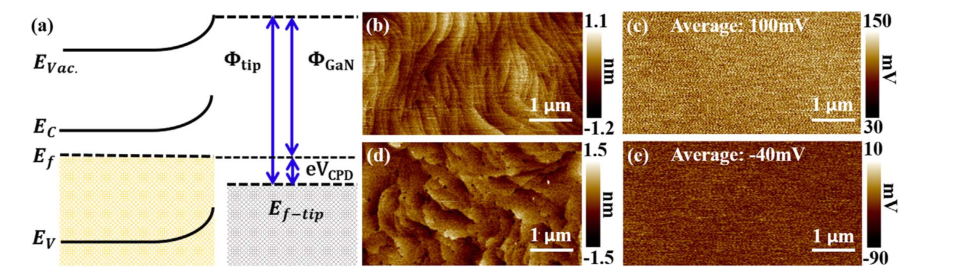
图1 VCPD测量原理示意图及表面形貌[1]
为了克服上述困难并进一步确定C掺杂的高电阻GaN的掺杂类型是n-型或p-型,对具有不同C浓度的GaN膜进行了PA-KPFM测量。图2(a)和2(b)显示了上述带隙PA-KPFM技术的示意图,其结果分别对应于nand-p型GaN,该技术可以通过识别照射后费米能级的移动方向来直接明确地确认掺杂类型,这归因于n/p型GaN的表面态和自发场捕获了电子/空穴。
基于这一事实,当施加照明时,电子被激发以进行带间跃迁,然后费米平衡被打破,从而形成电子(E ef)和空穴(E hf)的准费米能级。然后,由表面带弯曲引起的电场导致载流子移动。在n型GaN的情况下,如图2(a)所示,当空穴向表面移动时,空间电荷区中的电场导致多余的电子从表面扫走,因此在平衡后带弯曲将减小(如红色虚线所示)。因此,E ef电平将向上移动,因此VCPD将增加(表示为VCPD’)

图2 具有不同C浓度的GaN膜进行了PA-KPFM测量[1]
结果表示对于C浓度低于2×1018cm−3的GaN,C掺杂有利于费米能级的向下移动。而当C浓度超过转折点时,费米能级反而会向相反的方向移动,最终位于带隙的上部,导致n型导电性。n型导电性应当与高浓度的施主型补偿中心相关联。除了阐明C掺杂在GaN中与C浓度相关的复杂行为外,这项工作还为识别高电阻率GaN以及其他宽带隙半导体(如AlN和Ga2O3)的掺杂类型提供了必要的方法指导。
[1] Shan Wu etal2022 Jpn.J.Appl.Phys.61 090901
科学指南针已获得检验检测机构资质认定证书(CMA)、实验动物使用许可证、“ISO三体系认证”等专业认证,提供材料测试、高端测试、环境检测、生物服务、模拟计算、科研绘图、数据分析、试剂耗材、行业解决方案、指南针学院等多项科研产品和服务矩阵。企业致力于为高校、科研院所、医院、研发型企业等科研工作者,提供专业、快捷、全方位的检测及科研服务。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2024-09-27
2024-09-27
 4331
4331
 0
0










