【摘要】 随着单色仪技术的进步,电子能量损失谱(EELS)与扫描透射电子显微镜(STEM)相结合已成为一种有前途的纳米级半导体材料晶体和能带结构评估方法。
半导体材料中的缺陷严重影响其固有性能,因此评估局部缺陷及其能级对于控制器件性能至关重要。随着单色仪技术的进步,电子能量损失谱(EELS)与扫描透射电子显微镜(STEM)相结合已成为一种有前途的纳米级半导体材料晶体和能带结构评估方法。然而,关于局部缺陷结构与中隙状态之间关系的实验研究有限。在Shunsuke Yamashita等人的研究中,进行了能量分辨率小于100 meV的高能分辨率EELS (HR-EELS)测量,以检测GaN的中隙态。
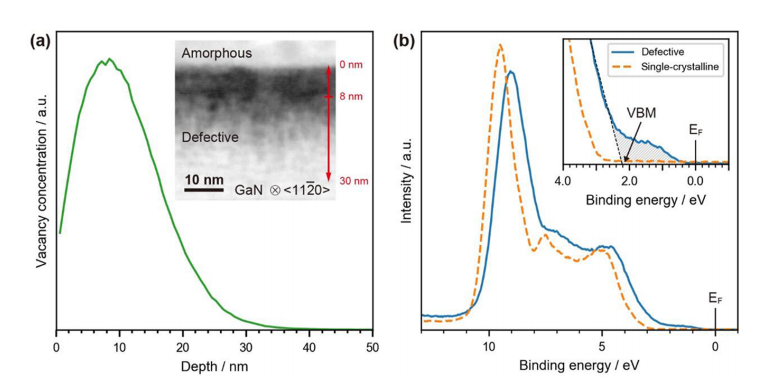
图1 镓离子植入GaN的细节。
图1(a)给出了空位的模拟深度分布,揭示了空位在~ 30 nm深度处的存在,在~ 8 nm处观察到的浓度最高。这个分布可以作为其他类型缺陷的参考。在插图中,亮场(BF)图像说明了表面附近明显的对比度变化,提供了缺陷形成的视觉证据。在深度方向上对不同缺陷浓度的GaN样品进行了HR-EELS测量,以研究中隙态的特征。为了诱导缺陷结构,利用聚焦离子束(FIB)系统在30 kV的加速电压下注入Gaion。同步加速器HAXPES测量证实了中隙态的形成。在此,主要通过EEL光谱成像来检测纳米尺度下的中隙态。请注意,虽然HAXPES评估的是VBM和EF之间的中间间隙状态,但HR-EELS评估的是整个能量间隙的中间间隙状态。图2(a)显示了与EEL光谱成像数据同时获取的ADF图像,图2b)显示了图2(a)中箭头所示的不同深度的价损光谱。为了提高信噪比,这些光谱在横向上使用12像素,在深度方向上使用4像素进行积分。作为参考光谱,我们使用了光谱#10和#11的平均值,因为在30 nm深度以外,由Gaion注入引起的缺陷数量可以忽略不计。光谱中的阴影区域表示与参考光谱相比的强度增加,清楚地表明在整个能隙中存在增强信号。
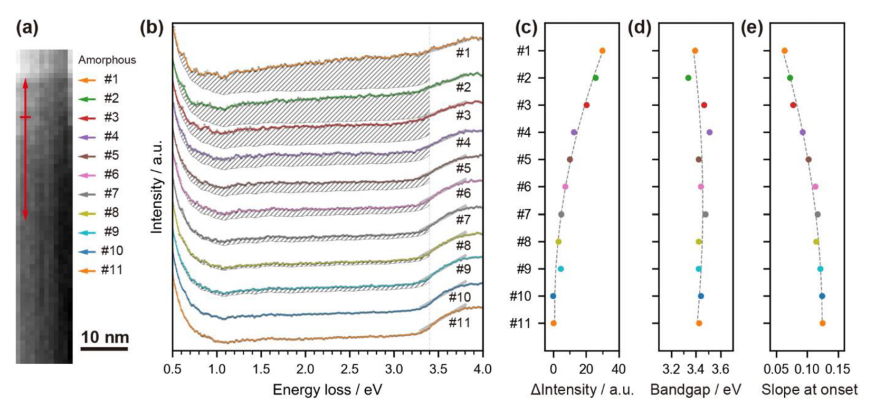
图2 镓离子注入GaN的深度相关EEL光谱。
这种情况的发生可归因于样品中各种缺陷的诱导,其中EEL光谱包括从价带到未占据的中隙状态的转变以及从占据的中隙状态到导带的转变值得注意的是,1.2 eV以下的强度向表面增加,表明EF和导带最小值(CBM)之间存在未占据的中隙态。请注意,HAXPES原则上不提供此信息。图2(c)显示了阴影区域的综合强度,对应于每个深度的中隙状态的数量。这一结果表明,中隙态的数量随深度的变化而变化,向表面形成的丰度更大。
研究集中在纳米尺度下中隙态的深度依赖行为,特别是分析了价损失谱的强度和形状。为了在纳米到原子尺度上探索诱导缺陷结构的起源,我们进行了4D-STEM分析和原子分辨率STEM观测。HR-EELS测量提供了深度依赖的价损谱,揭示了中隙态对应的强度逐渐向表面增加,而带间跃迁对应的起点斜率减小。此外,局部结构分析揭示了结构紊乱和缺陷结构的存在,表明存在层错和畴边界等扩展缺陷。可以观察到,这些缺陷构造在近地表大量存在,而在较深区域则不太明显。基于这些实验结果,得出结论,可以利用价损失谱的变化来定性地评估纳米尺度上的晶体缺陷。
[1] APL Mater. 12, 031101 (2024); doi: 10.1063/5.0178995 Submitted: 29 September 2023 • Accepted: 8 February 2024 •Published Online: 1 March 2024
科学指南针为您提供材料测试,主要业务范围包括XPS,普通XRD,透射电子显微镜TEM,全自动比表面及孔隙度分析BET等测试。
免责声明:部分文章整合自网络,因内容庞杂无法联系到全部作者,如有侵权,请联系删除,我们会在第一时间予以答复,万分感谢。











 您已经拒绝加入团体
您已经拒绝加入团体

 2024-05-15
2024-05-15
 4394
4394
 0
0










